|
 |
 |
射频ICP(感性耦合等离子体)发生装置的工作原理是:由射频源产生的射频功率(13.
56MHz)经射频电缆传输,至电感线圈耦合到石英或陶瓷腔中;感应的射频电场加热电子,电
离充入真空室中的工作气体产生高密度等离子体。等离子体扩散至下游处理室,用于在基片
表面沉积薄膜或刻蚀,或用于产生离子束等。 |
|
|
| 型 号 |
射频源 |
感应腔尺寸 |
感应线圈 |
| ICP |
TCP |
| ICP-1500等离子体源 |
1500W射频源 |
ф200×300 |
ф200×100 |
水冷感应线圈 |
| ICP-800等离子体源 |
800W射频源 |
ф150×220 |
ф150×80 |
水冷感应线圈 |
| ICP-300等离子体源 |
300W射频源 |
ф60×90 |
ф60×50 |
水冷感应线圈 |
|
|
| 型号 |
配用的等
离子体源 |
沉积室尺寸 |
基片台 |
抽充气系统 |
电控柜 |
| 直径 |
加热温度 |
CCPECVD
-1500 |
ICP-1500 |
ф450×300 |
200 |
450℃ |
1300L/s分子
泵两路流量计 |
1800
标准机柜 |
CCPECVD
-1500 |
ICP-800 |
ф350×400 |
150 |
450℃ |
600L/s分子
泵两路流量计 |
1400
标准机柜 |
CCPECVD
-1500 |
ICP-200 |
ф200×300 |
50 |
450℃ |
110L/s分子
泵两路流量计 |
1400
标准机柜 |
|
|
| 型号 |
射频源功率 |
刻蚀室尺寸 |
基片台 |
抽充气系统 |
电控柜 |
| 直径 |
冷却 |
ICP RIE
-1500 |
ICP-1500W |
ф450×300 |
200 |
水冷 |
1300L/s分子
泵两路流量计 |
1800
标准机柜 |
ICP RIE
-800 |
ICP-800W |
ф350×300 |
150 |
水冷 |
600L/s分子
泵两路流量计 |
1400
标准机柜 |
ICP RIE
-300 |
ICP-200W |
ф200×300 |
50 |
水冷 |
110L/s分子
泵两路流量计 |
1400
标准机柜 |
|
| |
| 4.射频ICP表面处理机有关参数与射频ICP刻蚀机类同 |
| |
|
| 型 号 |
配用的等
离子体源 |
三电极加
速栅尺寸 |
感应腔尺寸 |
感应线圈 |
| ICP |
TCP |
| ICP IB-1500 |
ICP-1500 |
ф200 |
100-2000 |
100-1000 |
1800标准机柜 |
| ICP IB-800 |
ICP-800 |
ф150 |
100-2000 |
60-600 |
1400标准机柜 |
| ICP IB-300 |
ICP-300 |
ф60 |
100-2000 |
10-100 |
1400标准机柜 |
| 2kV-50kV |
1-100 |
|
 |
 |
1.许沭华 任兆杏 沈克明 翁坚,射频ICP离子源设计研究,真空科学与技术,第
22卷 第4期 2002年7月。
2.XU Shu-hua(许沭华),Ren Zhao-xing(任兆杏),SHEN Ke-ming(沈克明)“Ex
traction Characteristics of Radio Frequency ICP Ion Source”,Plasma Sc
ience & Technology,Vol.4, No.4(2002);
3.XU Shu-hua(许沭华),Ren Zhao-xing(任兆杏)“Ions Bombardment in Thin
Films and Surface Processing”,Plasma Science & Technology,Vol.5, No.
3(2003);
4.离子束技术及其应用 |
 |
|
| |
| |
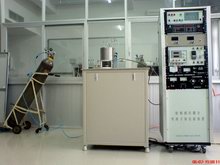 |
| 华南师范大学射频ICP装置 |
|
 |
|

